
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Yarı İletken Cihaz İmalat Sürecinin Tamamını Anlamak
1. Fotolitografi
Genellikle desen üretimiyle eşanlamlı olan fotolitografi, baskıdaki fotografik plaka oluşturma süreçlerinden kaynaklanan yarı iletken teknolojisinin hızlı ilerlemesinin arkasındaki en kritik itici güçlerden biridir. Bu teknik, herhangi bir desenin mikro veya nano ölçekte sunulmasına olanak tanır. fotodirenç ve diğer proses teknolojileriyle birleştirildiğinde bu desenleri malzemelere aktararak yarı iletken malzeme ve cihazların çeşitli tasarımlarını ve konseptlerini hayata geçirir. Fotolitografide kullanılan ışık kaynağı, ultraviyole, derin ultraviyole, X-ışını ve elektron ışınlarına kadar değişen seçeneklerle desenlerin kesinliğini doğrudan etkiler; bunların her biri, belirtilen sırayla artan desen doğruluğu düzeylerine karşılık gelir.
Standart bir fotolitografi proses akışı, yüzey hazırlama, yapışma, yumuşak pişirme, maruz bırakma, maruz kalma sonrası pişirme, geliştirme, sert pişirme ve incelemeyi içerir.
Substratlar tipik olarak havadan H2O moleküllerini emdiğinden ve fotolitografiye zararlı olduğundan yüzey işlemi zorunludur. Bu nedenle, substratlar başlangıçta pişirme yoluyla dehidrasyon işlemine tabi tutulur.
Hidrofilik substratlar için, bunların hidrofobik fotoreziste yapışması yetersizdir, potansiyel olarak fotorezistin ayrılmasına veya modelin yanlış hizalanmasına neden olur, dolayısıyla bir yapışma arttırıcıya ihtiyaç duyulur. Şu anda heksametil disilazan (HMDS) ve tri-metil-silil-dietil-amin (TMSDEA) yaygın olarak kullanılan yapışma arttırıcılardır.
Yüzey işleminin ardından fotorezist uygulamasına geçilir. Uygulanan fotorezistin kalınlığı sadece viskozitesiyle ilgili değildir, aynı zamanda döndürme kaplama hızından da etkilenir; genellikle döndürme hızının kareköküyle ters orantılıdır. Kaplamadan sonra, solventin fotorezistten buharlaştırılması için yumuşak bir pişirme işlemi gerçekleştirilir ve bu, ön pişirme olarak bilinen bir işlemde yapışmayı geliştirir.
Bu adımlar tamamlandıktan sonra maruz kalma gerçekleşir. Fotorezistler, maruz kaldıktan sonra zıt özelliklere sahip olarak pozitif veya negatif olarak sınıflandırılır.
Pozlanmamış fotorezistin geliştirici içinde çözünmediği, ancak maruz kaldıktan sonra çözünür hale geldiği örnek olarak pozitif fotorezisti ele alalım. Pozlama sırasında, desenli bir maskeden geçen ışık kaynağı, kaplanmış alt tabakayı aydınlatarak fotorezisti desenlendirir. Tipik olarak, pozlama konumunu tam olarak kontrol etmek için alt tabakanın pozlamadan önce maskeyle hizalanması gerekir. Desen bozulmasını önlemek için maruz kalma süresi sıkı bir şekilde yönetilmelidir. Maruziyet sonrası, duran dalga etkilerini azaltmak için ek pişirme gerekebilir, ancak bu adım isteğe bağlıdır ve doğrudan geliştirme lehine atlanabilir. Geliştirme, açığa çıkan fotorezisti çözerek maske desenini fotorezist katmanına doğru bir şekilde aktarır. Geliştirme süresi de kritiktir; çok kısa olması gelişimin tamamlanmamasına, çok uzun olması ise modelin bozulmasına yol açar.
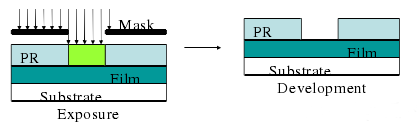
Daha sonra sert pişirme, fotorezist filmin alt tabakaya bağlanmasını güçlendirir ve aşınma direncini artırır. Sert pişirme sıcaklığı genellikle ön pişirmeden biraz daha yüksektir.
Son olarak mikroskobik inceleme, modelin beklentilere uygun olup olmadığını doğrular. Desen diğer işlemlerle malzemeye aktarıldıktan sonra fotorezist amacına hizmet etmiştir ve kaldırılması gerekir. Sıyırma yöntemleri arasında ıslak (aseton gibi güçlü organik çözücüler kullanılarak) ve kuru (filmi aşındırmak için oksijen plazması kullanılarak) yer alır.
2. Doping Teknikleri
Yarı iletken malzemelerin elektriksel özelliklerini gerektiği gibi değiştiren doping, yarı iletken teknolojisinde vazgeçilmezdir. Yaygın doping yöntemleri arasında termal difüzyon ve iyon implantasyonu bulunur.
(1) İyon İmplantasyonu
İyon implantasyonu, yarı iletken substratı yüksek enerjili iyonlarla bombardıman ederek katkılar. Termal difüzyonla karşılaştırıldığında birçok avantajı vardır. Kütle analizörü tarafından seçilen iyonlar yüksek katkılama saflığı sağlar. İmplantasyon boyunca substrat oda sıcaklığında veya biraz daha yüksek sıcaklıkta kalır. Kendinden hizalı maske teknikleriyle yüksek esneklik sağlayan silikon dioksit (SiO2), silikon nitrür (Si3N4) ve fotorezist gibi birçok maskeleme filmi kullanılabilir. İmplant dozları hassas bir şekilde kontrol edilir ve implante edilen safsızlık iyon dağılımı aynı düzlem içinde tekdüzedir, bu da yüksek tekrarlanabilirlik sağlar.
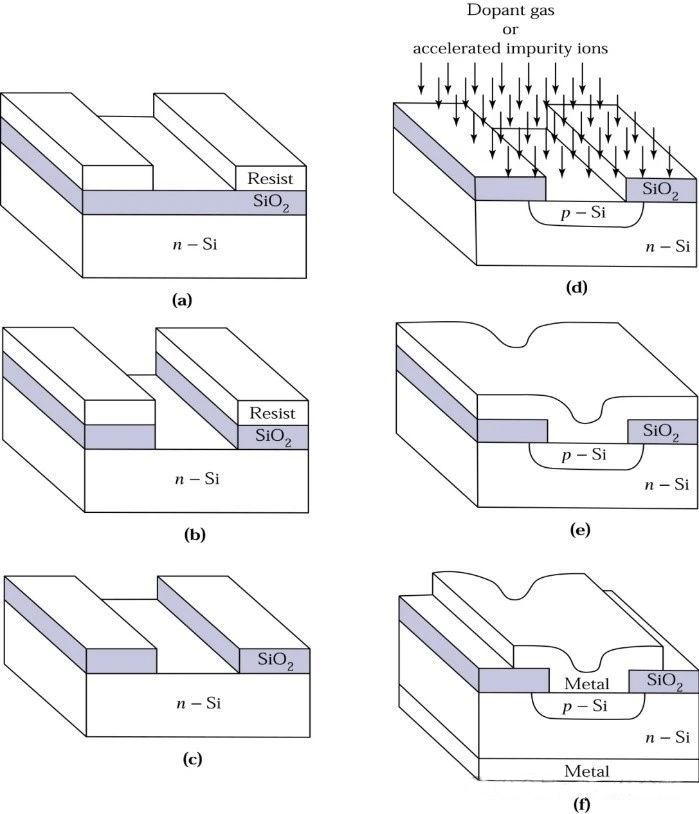
İmplantasyon derinliği iyonların enerjisine göre belirlenir. Enerji ve dozu düzenleyerek, implantasyon sonrası substrattaki safsızlık iyonlarının dağılımı değiştirilebilir. Çeşitli safsızlık profillerine ulaşmak için çeşitli şemalarla çoklu implantasyonlar sürekli olarak gerçekleştirilebilir. Özellikle tek kristalli substratlarda, implantasyon yönü kristalografik yöne paralel ise kanal etkileri meydana gelir; bazı iyonlar kanallar boyunca ilerleyerek derinlik kontrolünü zorlaştırır.
Kanallaşmayı önlemek için implantasyon tipik olarak tek kristalli substratın ana eksenine yaklaşık 7°'lik bir açıyla veya substratı amorf bir katmanla kaplayarak gerçekleştirilir.
Ancak iyon implantasyonu substratın kristal yapısına önemli ölçüde zarar verebilir. Yüksek enerjili iyonlar çarpışma üzerine enerjiyi substratın çekirdeklerine ve elektronlarına aktararak bunların kafesten ayrılmasına ve arayer boşluk kusur çiftleri oluşturmasına neden olur. Şiddetli vakalarda bazı bölgelerdeki kristal yapı bozularak amorf bölgeler oluşabilir.
Kafes hasarı, taşıyıcı hareketliliğini veya denge dışı taşıyıcıların ömrünü azaltmak gibi yarı iletken malzemenin elektriksel özelliklerini büyük ölçüde etkiler. En önemlisi, implante edilen safsızlıkların çoğunluğu düzensiz interstisyel bölgeleri işgal ederek etkili katkılama oluşturmayı başaramaz. Bu nedenle implantasyon sonrası kafes hasarı onarımı ve safsızlıkların elektriksel aktivasyonu esastır.
Termal tavlama, iyon implantasyonunun ve elektriksel olarak aktifleşen yabancı maddelerin neden olduğu kafes hasarını düzeltmek için en etkili yöntemdir. Yüksek sıcaklıklarda, alt tabakanın kristal kafesindeki ara boşluk kusuru çiftleri yeniden birleşecek ve kaybolacaktır; amorf bölgeler ayrıca katı faz epitaksi yoluyla tek kristalli alanlarla sınırdan yeniden kristalleşecektir. Substrat malzemesinin yüksek sıcaklıklarda oksitlenmesini önlemek için termal tavlama, vakum veya inert gaz atmosferinde gerçekleştirilmelidir. Geleneksel tavlama uzun zaman alır ve difüzyon nedeniyle önemli miktarda yabancı maddenin yeniden dağıtımına neden olabilir.
gelişiRTP teknolojisikafes hasarı onarımını ve safsızlık aktivasyonunu kısaltılmış bir tavlama süresi içinde büyük ölçüde gerçekleştirerek bu sorunu giderir.
Isı kaynağına bağlı olarak,RTPçeşitli tiplere ayrılmıştır: elektron ışını taraması, darbeli elektron ve iyon ışınları, darbeli lazerler, sürekli dalga lazerleri ve geniş bantlı tutarsız ışık kaynakları (halojen lambalar, grafit ısıtıcılar, ark lambaları), ikincisi en yaygın kullanılanıdır. Bu kaynaklar, alt tabakayı anında gerekli sıcaklığa ısıtabilir, tavlamayı kısa sürede tamamlayabilir ve safsızlık difüzyonunu etkili bir şekilde azaltabilir.
3. Film Biriktirme Teknikleri
(1) Plazmayla Geliştirilmiş Kimyasal Buhar Biriktirme (PECVD)
PECVD, film biriktirme için Kimyasal Buhar Biriktirme (CVD) tekniğinin bir biçimidir; diğer ikisi Atmosfer Basıncı CVD (APCVD) ve Düşük Basınç CVD'dir (LPCVD).
Şu anda PECVD, üç tip arasında en yaygın olarak uygulananıdır. Nispeten düşük sıcaklıklarda kimyasal reaksiyonları başlatmak ve sürdürmek için radyo frekansı (RF) plazmasını kullanır, dolayısıyla yüksek biriktirme oranlarıyla düşük sıcaklıkta film biriktirmeyi kolaylaştırır. Ekipman şeması resimdeki gibidir.
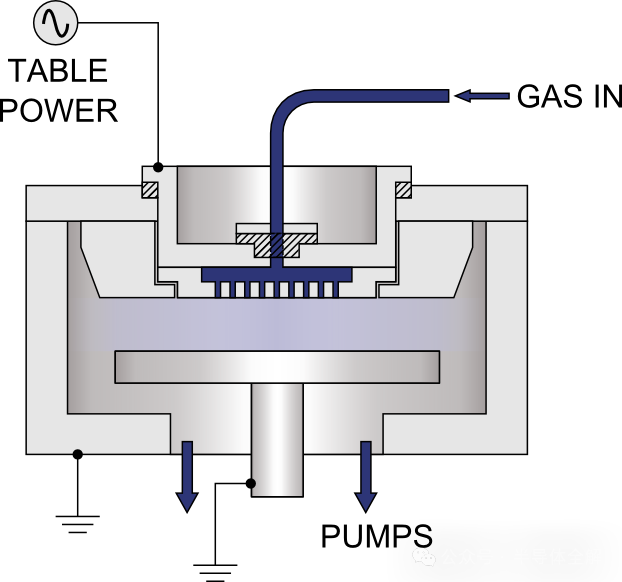
Bu yöntemle üretilen filmler olağanüstü yapışma ve elektriksel özellikler, minimum mikro gözeneklilik, yüksek tekdüzelik ve sağlam küçük ölçekli doldurma yetenekleri sergiler. PECVD biriktirme kalitesini etkileyen faktörler arasında alt katman sıcaklığı, gaz akış hızı, basınç, RF gücü ve frekans yer alır.
(2) Püskürtme
Püskürtme bir Fiziksel Buhar Biriktirme (PVD) yöntemidir. Yüklü iyonlar (genellikle Argon iyonları, Ar+) bir elektrik alanında hızlandırılarak kinetik enerji kazanırlar. Hedef malzemeye doğru yönlendirilirler, hedef moleküllerle çarpışırlar ve onların yerlerinden çıkıp etrafa saçılmasına neden olurlar. Bu moleküller ayrıca önemli bir kinetik enerjiye sahiptir ve substrata doğru hareket ederek üzerinde birikirler.

Tipik olarak kullanılan püskürtme güç kaynakları arasında, DC püskürtmenin metaller gibi iletken malzemelere doğrudan uygulanabildiği Doğru Akım (DC) ve Radyo Frekansı (RF) yer alır; yalıtım malzemeleri ise film biriktirme için RF püskürtme gerektirir.
Geleneksel püskürtme, düşük biriktirme oranlarından ve yüksek çalışma basınçlarından muzdariptir ve bu da daha düşük film kalitesine neden olur. Magnetron püskürtme bu sorunları daha ideal bir şekilde çözer. İyonların doğrusal yörüngesini manyetik alan yönü etrafında sarmal bir yola dönüştürmek için harici bir manyetik alan kullanır, yollarını uzatır ve hedef moleküllerle çarpışma verimliliğini artırır, böylece püskürtme verimliliğini artırır. Bu, biriktirme oranlarının artmasına, çalışma basınçlarının azalmasına ve film kalitesinin önemli ölçüde artmasına neden olur.
4. Dağlama Teknikler
Aşındırma, sırasıyla belirli çözümlerin kullanımına (veya eksikliğine) göre adlandırılan kuru ve ıslak modlara göre sınıflandırılır.
Tipik olarak aşındırma, aşındırmaya yönelik olmayan bölgeleri korumak için bir maske katmanının (doğrudan ışığa dirençli olabilen) hazırlanmasını gerektirir.
(1) Kuru Dağlama
Yaygın kuru aşındırma türleri şunları içerir:İndüktif Eşleşmiş Plazma (ICP) aşındırma, İyon Işınıyla Aşındırma (IBE) ve Reaktif İyon Aşındırma (RIE).
ICP aşındırmada, kızdırma deşarjı ile üretilen plazma, uçucu ürünler oluşturmak üzere hedef malzeme ile kimyasal olarak reaksiyona giren ve böylece dağlamanın elde edildiği çok sayıda kimyasal olarak aktif serbest radikalleri (serbest atomlar, moleküller veya atomik gruplar) içerir.
IBE, fiziksel bir süreci temsil eden aşındırma için hedef malzemenin yüzeyini doğrudan bombardıman etmek üzere yüksek enerjili iyonları (inert gazlardan iyonize edilmiş) kullanır.
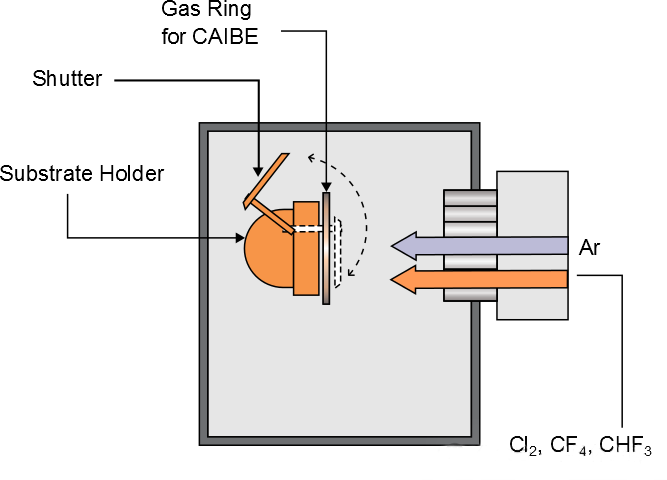
RIE, önceki ikisinin bir kombinasyonu olarak kabul edilir; IBE'de kullanılan inert gaz, ICP dağlamada kullanılan gazla değiştirilir ve böylece RIE oluşturulur.
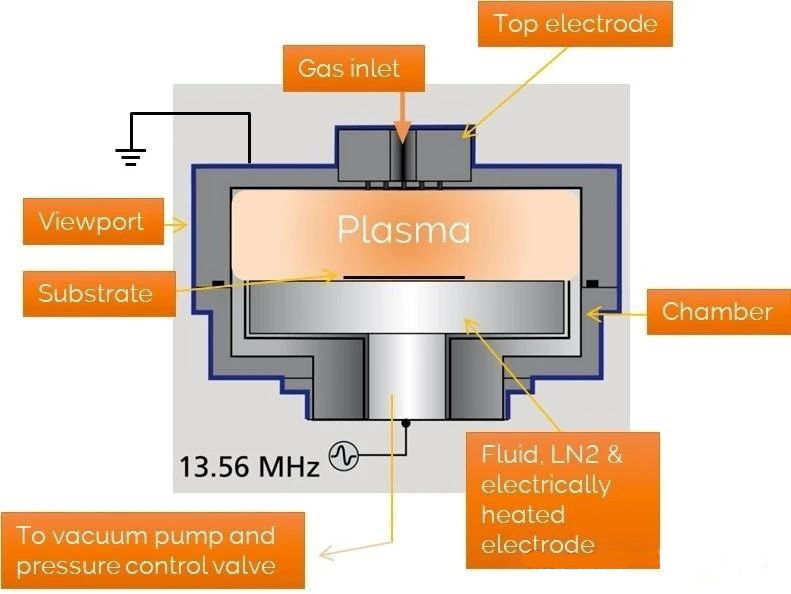
Kuru aşındırma için dikey aşındırma hızı, yanal hızı çok aşar; yani yüksek bir en-boy oranına sahiptir ve maske modelinin hassas şekilde kopyalanmasına olanak tanır. Bununla birlikte, kuru aşındırma aynı zamanda maske katmanını aşındırarak daha zayıf seçicilik (hedef malzemenin aşındırma oranlarının maske katmanına oranı) gösterir, özellikle malzemenin yüzeyi boyunca seçici olmayan bir şekilde aşındırabilen IBE ile.
(2) Islak Dağlama
Islak aşındırma, hedef malzemenin kendisiyle kimyasal olarak reaksiyona giren bir çözeltiye (asitleyici) daldırılmasıyla elde edilen aşındırma yöntemini ifade eder.
Bu aşındırma yöntemi basit, uygun maliyetlidir ve iyi bir seçicilik gösterir ancak en boy oranı düşüktür. Maske kenarlarının altındaki malzeme aşınabilir, bu da kuru aşındırma işlemine göre daha az hassas olmasını sağlar. Düşük en boy oranının olumsuz etkilerini azaltmak için uygun aşındırma oranları seçilmelidir. Aşındırma oranını etkileyen faktörler arasında aşındırma konsantrasyonu, aşındırma süresi ve aşındırma sıcaklığı yer alır.**




