
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Talaş Üretiminde SiGe: Profesyonel Bir Haber Raporu
Yarı İletken Malzemelerin Evrimi
Modern yarı iletken teknolojisi alanında minyatürleştirmeye yönelik aralıksız çaba, geleneksel silikon bazlı malzemelerin sınırlarını zorladı. Yüksek performans ve düşük güç tüketimi taleplerini karşılamak için SiGe (Silikon Germanyum), benzersiz fiziksel ve elektriksel özellikleri nedeniyle yarı iletken çip üretiminde tercih edilen kompozit malzeme olarak ortaya çıkmıştır. Bu makale konuyu ele alıyorepitaksi süreciSiGe'nin yapısı ve epitaksiyel büyümedeki rolü, gerilmiş silikon uygulamaları ve Her Yerde Kapı (GAA) yapıları.
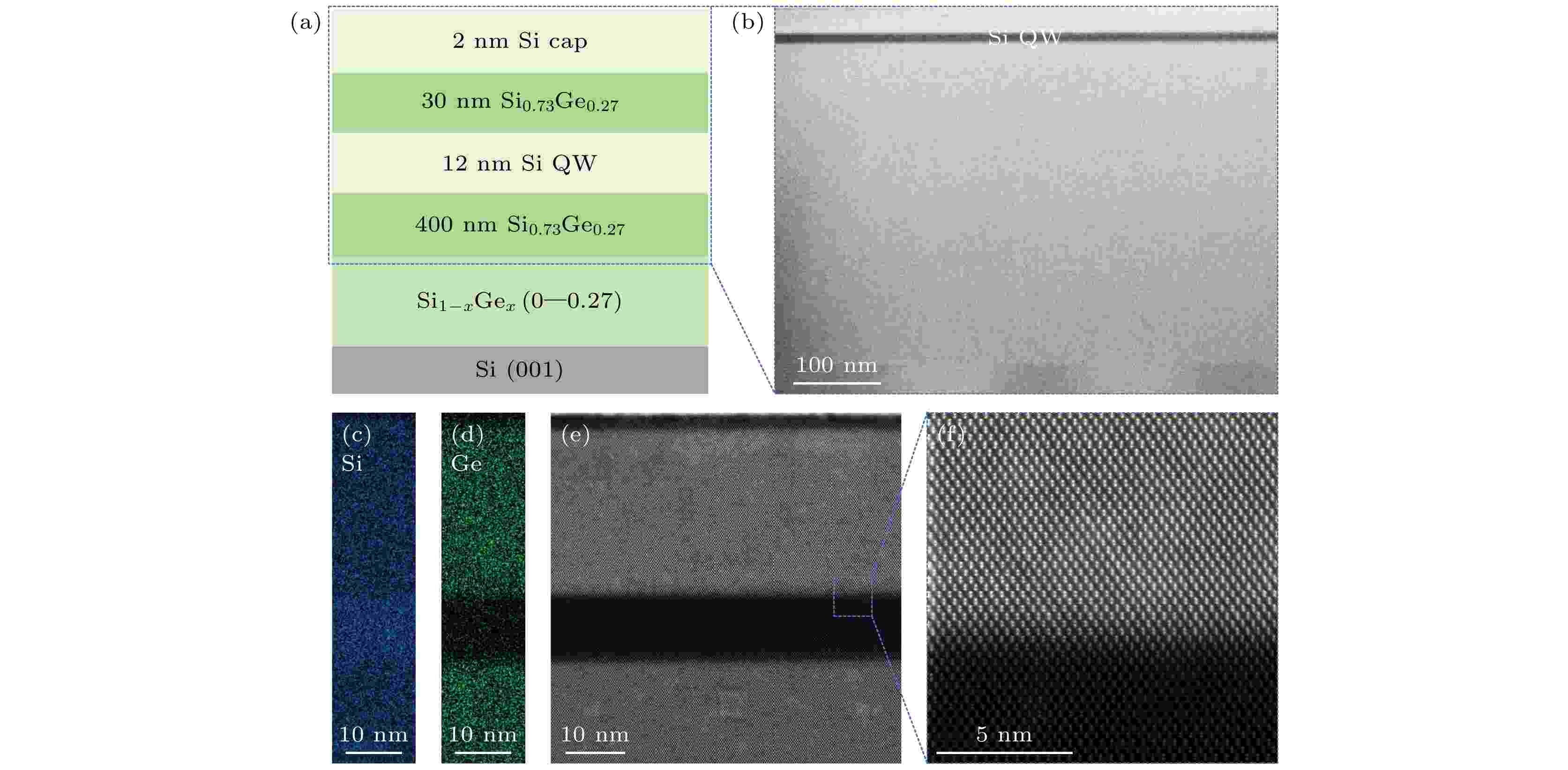
SiGe Epitaksinin Önemi
1.1 Çip Üretiminde Epitaksiye Giriş:
Genellikle Epi olarak kısaltılan epitaksi, aynı kafes düzenlemesine sahip tek kristalli bir substrat üzerinde tek kristalli bir katmanın büyümesini ifade eder. Bu katman şunlardan biri olabilir:homoepitaksiyel (Si/Si gibi)veya heteroepitaksiyel (SiGe/Si veya SiC/Si gibi). Epitaksiyel büyüme için Moleküler Işın Epitaksi (MBE), Ultra Yüksek Vakumlu Kimyasal Buhar Biriktirme (UHV/CVD), Atmosfer ve Azaltılmış Basınç Epitaksi (ATM ve RP Epi) dahil olmak üzere çeşitli yöntemler kullanılır. Bu makale, alt tabaka malzemesi olarak silikon kullanılarak yarı iletken entegre devre üretiminde yaygın olarak kullanılan silikon (Si) ve silikon-germanyumun (SiGe) epitaksi işlemlerine odaklanmaktadır.
1.2 SiGe Epitaksinin Avantajları:
Belirli bir oranda germanyum (Ge) eklenmesiepitaksi süreciyalnızca bant aralığı genişliğini azaltmakla kalmayıp aynı zamanda transistörün kesme frekansını (fT) da artıran bir SiGe tek kristal katmanı oluşturur. Bu, kablosuz ve optik iletişim için yüksek frekanslı cihazlarda yaygın olarak uygulanabilir olmasını sağlar. Üstelik gelişmiş CMOS entegre devre süreçlerinde Ge ve Si arasındaki kafes uyumsuzluğu (yaklaşık %4) kafes gerilimine neden olur, elektronların veya deliklerin hareketliliğini artırır ve böylece cihazın doyma akımını ve tepki hızını artırır.
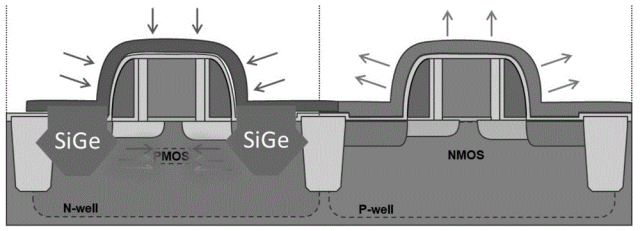
Kapsamlı SiGe Epitaksi Proses Akışı
2.1 Ön arıtma:
Silikon plakalar, öncelikle doğal oksit tabakasının ve plaka yüzeyindeki yabancı maddelerin uzaklaştırılmasını içeren, istenen işlem sonuçlarına göre ön işleme tabi tutulur. Ağır katkılı alt tabaka plakaları için, sonraki işlemlerde otomatik katkılamayı azaltmak için arka yalıtımın gerekli olup olmadığını dikkate almak çok önemlidir.epitaksi büyümesi.
2.2 Büyüme Gazları ve Koşulları:
Silikon gazları: Silan (SiH₄), Diklorosilan (DCS, SiH₂Cl₂) ve Triklorosilan (TCS, SiHCl₃), en yaygın kullanılan üç silikon gazı kaynağıdır. SiH₄ düşük sıcaklıktaki tam epitaksi işlemleri için uygundur; hızlı büyüme oranıyla bilinen TCS ise kalın malzemelerin hazırlanmasında yaygın olarak kullanılır.silikon epitaksikatmanlar.
Germanyum gazı: Germane (GeH₄), SiGe alaşımları oluşturmak için silikon kaynaklarıyla birlikte kullanılan germanyumun eklenmesi için birincil kaynaktır.
Seçici epitaksi: Seçici büyüme, bağıl oranlar ayarlanarak elde edilir.epitaksiyel birikimve klor içeren silikon gazı DCS kullanılarak yerinde aşındırma. Seçicilik, Cl atomlarının silikon yüzeyindeki adsorpsiyonunun oksitler veya nitrürlerdekinden daha az olması ve epitaksiyel büyümeyi kolaylaştırmasından kaynaklanmaktadır. Cl atomlarından yoksun ve düşük aktivasyon enerjisine sahip SiH₄, genellikle yalnızca düşük sıcaklıktaki tam epitaksi işlemlerine uygulanır. Yaygın olarak kullanılan bir başka silikon kaynağı olan TCS, düşük buhar basıncına sahiptir ve oda sıcaklığında sıvıdır, reaksiyon odasına girmesi için H₂ kabarcıklanması gerektirir. Bununla birlikte, nispeten ucuzdur ve silikon epitaksi gofret üretiminde yaygın olarak uygulanan daha kalın silikon epitaksi katmanlarını büyütmek için hızlı büyüme oranı (5 μm / dakikaya kadar) nedeniyle sıklıkla kullanılır.
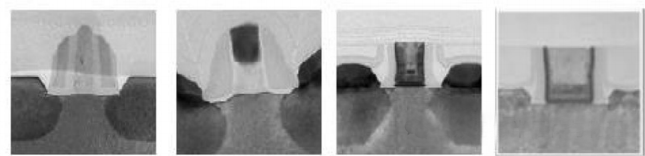
Epitaksiyel Katmanlarda Gerilmiş Silikon
Sırasındaepitaksiyel büyüme, epitaksiyel tek kristal Si, rahat bir SiGe katmanı üzerinde biriktirilir. Si ve SiGe arasındaki kafes uyumsuzluğu nedeniyle, Si tek kristal katmanı, alttaki SiGe katmanından gelen çekme gerilimine maruz kalır ve NMOS transistörlerindeki elektron hareketliliğini önemli ölçüde artırır. Bu teknoloji yalnızca doygunluk akımını (Idsat) artırmakla kalmaz, aynı zamanda cihazın tepki hızını da artırır. PMOS cihazları için, SiGe katmanları, kanal üzerinde sıkıştırma gerilimi oluşturmak, delik hareketliliğini arttırmak ve doyma akımını arttırmak için aşındırma sonrasında kaynak ve drenaj bölgelerinde epitaksiyel olarak büyütülür.
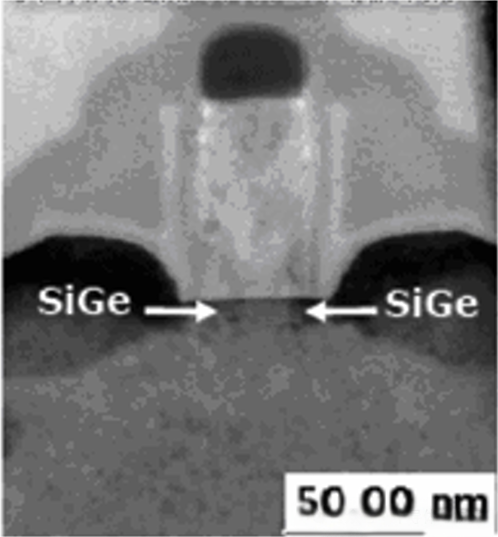
GAA Yapılarında Kurban Katmanı Olarak SiGe
Gate-All-Around (GAA) nanotel transistörlerinin üretiminde SiGe katmanları fedakar katmanlar gibi davranır. Yarı atomik katman aşındırma (yarı-ALE) gibi yüksek seçiciliğe sahip anizotropik aşındırma teknikleri, nanotel veya nano tabaka yapıları oluşturmak için SiGe katmanlarının hassas bir şekilde çıkarılmasına olanak tanır.
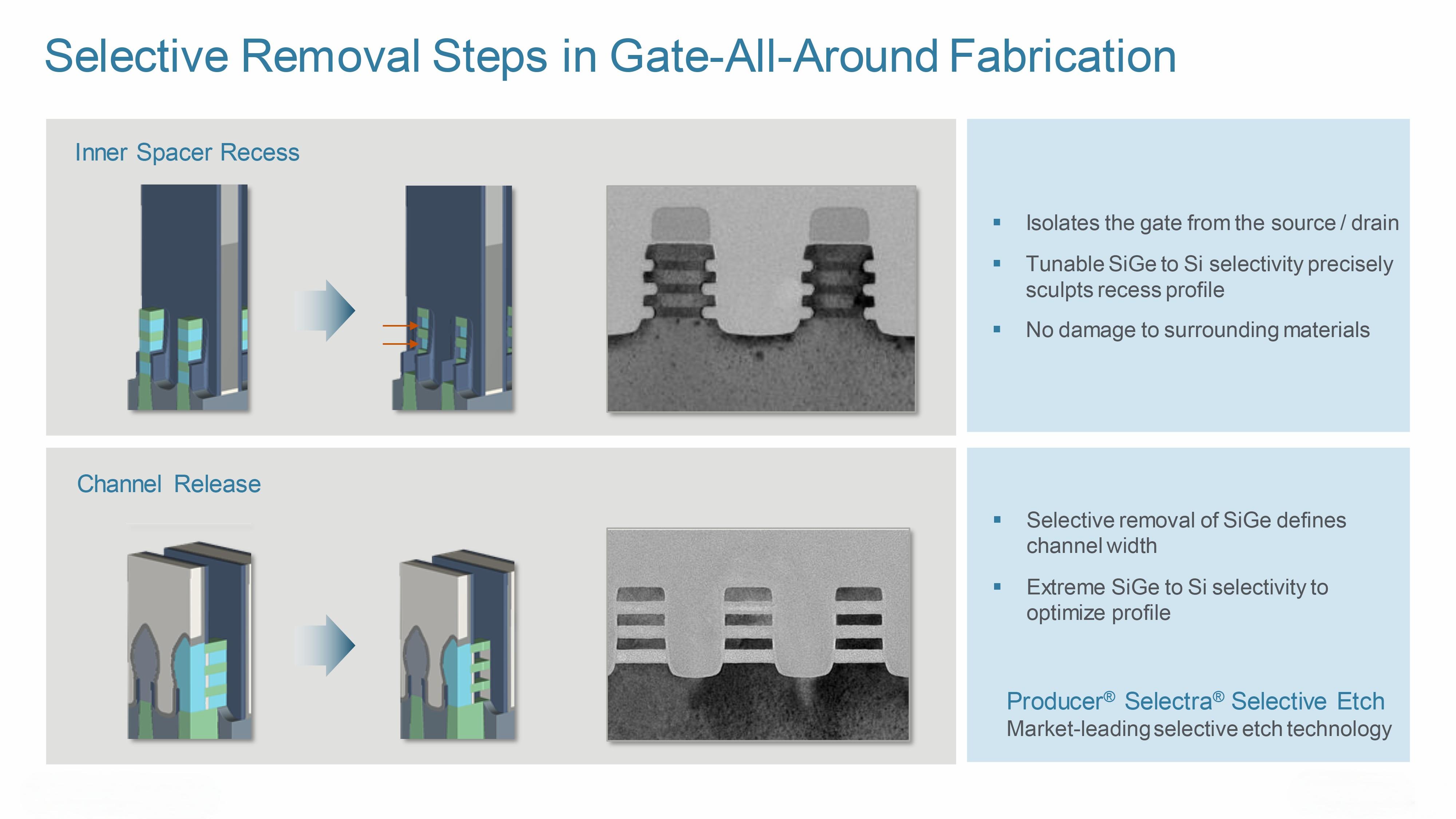
Semicorex olarak biz şu konuda uzmanız:SiC/TaC kaplı grafit çözümleriYarı iletken üretiminde Si epitaksiyel büyümede uygulanmıştır. Herhangi bir sorunuz varsa veya ek ayrıntılara ihtiyacınız varsa lütfen bizimle iletişime geçmekten çekinmeyin.
İletişim telefonu: +86-13567891907
E-posta: sales@semicorex.com




